-

VSI6X制砂机
进料粒度: 0-60mm
产量: 109-839t/h

CS弹簧圆锥破碎机
进料粒度: 0-370mm
产量: 45-780t/h

CI5X系列反击式破碎机
进料粒度: 0-1300mm
产量: 150-2000t/h

GF系列给料机
进料粒度: 0-1500mm
产量: 400-2400t/h

HGT旋回式破碎机
进料粒度: 0-1570mm
产量: 2015-8895t/h

HPT液压圆锥破碎机
进料粒度: 0-350mm
产量: 0-350mmt/h

HST液压圆锥破碎机
进料粒度: 0-560mm
产量: 45-2130t/h

C6X系列颚式破碎机
进料粒度: 0-1200mm
产量: 80-1510t/h

NK系列移动站
进料粒度: 0-680mm
产量: 100-500t/h

MK系列破碎筛分站
进料粒度: 0-900mm
产量: 100-500t/h

S5X系列圆振动筛
进料粒度: 0-300mm
产量: 45-2250t/h
-

VSI6X制砂机
进料粒度: 0-60mm
产量: 109-839t/h

CS弹簧圆锥破碎机
进料粒度: 0-370mm
产量: 45-780t/h

CI5X系列反击式破碎机
进料粒度: 0-1300mm
产量: 150-2000t/h

HGT旋回式破碎机
进料粒度: 0-1570mm
产量: 2015-8895t/h

HPT液压圆锥破碎机
进料粒度: 0-350mm
产量: 0-350mmt/h

HST液压圆锥破碎机
进料粒度: 0-560mm
产量: 45-2130t/h

C6X系列颚式破碎机
进料粒度: 0-1200mm
产量: 80-1510t/h

S5X系列圆振动筛
进料粒度: 0-300mm
产量: 45-2250t/h
-

NK系列移动站
进料粒度: 0-680mm
产量: 100-500t/h

MK系列破碎筛分站
进料粒度: 0-900mm
产量: 100-500t/h
-

GF系列给料机
进料粒度: 0-1500mm
产量: 400-2400t/h

S5X系列圆振动筛
进料粒度: 0-300mm
产量: 45-2250t/h
disco研磨机可以研磨到多少厚度

DFG8560研磨機產品介紹DISCOCorporation
經由上述做法,提高了晶圓本身,以及晶圓和晶圓之間的平坦度,在超薄研磨時可以有穩定的品質。維持與以往機型的互換性研磨輪,磨刀板(DressingBoard),主軸及工作

DFG8340研磨機產品介紹DISCOCorporation
穩定的晶圓高精度加工.隨著產品元件高積體化的發展,追求高平坦度的晶圓製造工程中也開始採用表面研磨(Grinding)技術。.作為在世界各地備受好評的DFG830後繼機種

減薄精加工研磨研磨解決方案DISCO
如照片1所示,只對Φ300mm矽晶片進行研磨加工,就可將晶片的厚度減薄加工至5µm。通過將本期介紹的設備,磨具以及研磨條件進行最佳組合,即使只使用通常的研磨方式也能夠減薄加工到這麼薄的程度。照片1t5µm

减薄精加工研削研削解决方案DISCO
提高抗折强度(去除应力加工).虽然通过采用Poligrind磨轮进行研削加工,可提高减薄精加工的加工质量。.但由于使用的是磨轮,所以在晶片表面仍然会残留下细微的破碎层。.为了去除表面残留的破碎层,进一步提高芯
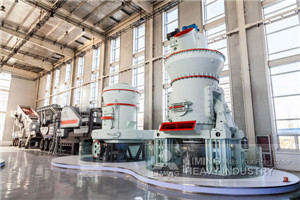
追求更高效率的300mm研磨拋光机DISCOHITECCHINA
追求更高效率的300mm研磨拋光机提高加工稳定性,实现更高产能效率DGP8761是全球销售业绩突出的DGP8760的改良机型。本机型实现了背面研磨到去除

产品信息研削机DISCOHITECCHINA
Grinder.可对硅晶片或化合物半导体等多种材料进行高精度研削的装置。.通过与抛光机或晶片框架粘贴机的连接,也可对应使用DBG系统和DAF(DieAttachFilm)的相关应用技术

DISCO:一家少被提及的半导体设备巨头,硅片,刀片,研磨机
DISCO:一家少被提及的半导体设备巨头,硅片,半导体,刀片,研磨机,半导体设备DISCO:世界级封测设备巨头DISCO是一家日本公司,其核心竞争力是将制造的

晶圆背面研磨(BackGrinding)决定晶圆的厚度,晶圆研磨,国瑞升
背面研磨(BackGrinding)决定晶圆的厚度.经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(BackGrinding)开始后端处理。.背面研磨是将晶圆背面磨

背面研磨(BackGrinding)决定晶圆的厚度SKhynixNewsroom
.经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(BackGrinding)开始后端处理。.背面研

DFG8340研磨機產品介紹DISCOCorporation
穩定的晶圓高精度加工.隨著產品元件高積體化的發展,追求高平坦度的晶圓製造工程中也開始採用表面研磨(Grinding)技術。.作為在世界各地備受好評的DFG830後繼機種的DFG8340,透過搭載高剛性主軸並將加工時所產生的熱影響降低到最小,實現穩定的晶圓高

DISCO|鲜被提及的半导体设备巨头面包板社区
DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。.他们的公司座右铭是Kiru,Kezuru,Migaku,意思是切割、研磨和抛光。.DISCO在晶圆研磨机、砂轮、晶圆切割锯、激光锯和表面平坦化的生产中

自动胡佛式色散特性研磨机厂商报价仪器信息网
技术参数研磨光纤参数角度范围0度至45度角度重复性±0.5度研磨速度可用户调节研磨片尺寸4”备注:Radian™研磨机的精密转动平台可以连续调节以实现大范围光纤尖部角度研磨研磨角度可调可支持连接头研磨示例图相关问答总结1、你好,60°可以抛光吗?

DISCO:一家少被提及的半导体设备巨头公司硅片工具
DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。.他们的公司座右铭是Kiru,Kezuru,Migaku,意思是切割、研磨和抛光。.DISCO在晶圆研磨机、砂轮、晶圆切割锯、激光锯和表面平坦化的生产中

一家少被提及的半导体设备巨头,硅片,刀片,研磨机网易订阅
一家少被提及的半导体设备巨头.DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的鬼片,然后将其切割成die,然后组装成电子产品。.他们的公司座右铭是Kiru,Kezuru,Migaku,意思是切割、研磨和抛光。.DISCO在晶圆研磨机、砂轮、晶圆切割

中国“金矿之都”发现50吨金矿!关于金矿选矿工艺,你知道多少
在第一步中,金矿石已经被破碎成约010mm小颗粒,已经满足输送到金矿石研磨机——球磨机的需求。在料仓、振动给料机的作用下,这些小颗粒被均匀输送到球磨机中进行研磨,然后由分级机、水利旋流器等设备进行分级筛选,直到所有金矿石粉达到下一级生产作业的需求。

晶圆背面研磨(BackGrinding)决定晶圆的厚度,晶圆研磨,国瑞升
背面研磨(BackGrinding)决定晶圆的厚度.经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(BackGrinding)开始后端处理。.背面研磨是将晶圆背面磨薄的工序,其目的不仅是为了减少晶圆厚度,还在于联结前端和后端工艺以解决前后两个工艺之间出
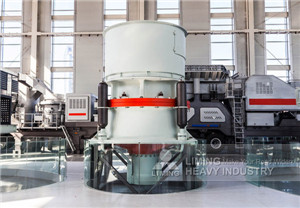
消除晶圆背面减薄过程产生的异常研磨印迹的方法与流程
今天.本申请涉及半导体技术领域,具体涉及一种消除晶圆背面减薄过程产生的异常研磨印迹的方法。背景技术.在后段制程阶段,晶圆(正面已布好电路的硅片)在后续划片、压焊和封装之前需要进行背面减薄加工以降低封装贴装高度,减小芯片封装体积,改善芯片的热扩散效率、电气性能、机械性能及

机加工成本核算核价方法百度文库
确定时间定额应根据本企业的生产技术条件,使大多数工人经过努力都能达到,部分先进工人可以超出,少数工人经过努力可以达到或接近平均先进水平。随着企业生产技术条件的不断改善,时间定额定期进行修订,以保持定额的平均先进水平。☆铣床

汕尾半导体划片机项目投资计划书模板范文】.docx豆丁网
同时,随着晶圆减薄工艺技术的发展以及叠层封装技术的成熟,芯片的厚度越来越薄,对晶圆切割划片设备性能的要求也越来越高,作为IC后封装生产过程中关键设备之一的晶圆切割划片机,也由150mm、200mm发展到300mm。

DISCO:一家少被提及的半导体设备巨头DISCO:世界级封
DISCO:世界级封测设备巨头.DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。.他们的公司座右铭是Kiru,Kezuru,Migaku,意思是切割、研磨和抛光。.DISCO在晶圆研磨机、砂轮、晶圆切割锯

2023年半导体行业专题研究报告全球半导体切磨抛设备材料
而晶圆贴膜机是为了处理12寸超薄晶圆,特意与背面研磨机组成联机系统的晶圆贴膜机,针对研磨薄化后的晶圆,可安全可靠地实施从粘贴切割胶膜到框架上,再到剥离表面保护胶膜为止的一系列工序,是一项实现高良率薄型化技术的专用设备。

DISCO:一家少被提及的半导体设备巨头公司硅片工具
DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。.他们的公司座右铭是Kiru,Kezuru,Migaku,意思是切割、研磨和抛光。.DISCO在晶圆研磨机、砂轮、晶圆切割锯、激光锯和表面平坦化的生产中
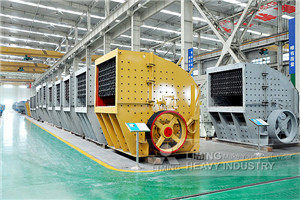
颗粒磨到多细?能磨到200nm左右吗?分析百问分析测试

WaferThinning一般研磨NoniST宜特
MOSFET晶圆减薄(waferthinning)的背面研磨工艺中BG,利用研磨轮,进行快速而精密之研磨Grinding后,再以蚀刻液进行表面微蚀刻,藉以去除因研磨产生的破坏层,并释放应力。宜特可为客户提供厚度

详解硅片的研磨、抛光和清洗技术今日头条电子发烧友网
详解硅片的研磨、抛光和清洗技术在半导体和LED的制造中,需要研磨以使晶片的厚度变薄,以及抛光以使表面成为镜面。在半导体器件的制造中,半导体制造工艺包括:(1)从晶体生长开始切割和抛光硅等,并将其加工成晶片形状的工艺(晶片制造工艺);(2)在晶片上形成IC的工艺(前一工艺

汕尾半导体划片机项目投资计划书模板范文】.docx豆丁网
同时,随着晶圆减薄工艺技术的发展以及叠层封装技术的成熟,芯片的厚度越来越薄,对晶圆切割划片设备性能的要求也越来越高,作为IC后封装生产过程中关键设备之一的晶圆切割划片机,也由150mm、200mm发展到300mm。
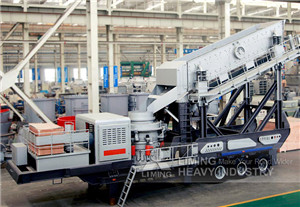
中国“金矿之都”发现50吨金矿!关于金矿选矿工艺,你知道多少
在第一步中,金矿石已经被破碎成约010mm小颗粒,已经满足输送到金矿石研磨机——球磨机的需求。在料仓、振动给料机的作用下,这些小颗粒被均匀输送到球磨机中进行研磨,然后由分级机、水利旋流器等设备进行分级筛选,直到所有金矿石粉达到下一级生产作业的需求。

机加工成本核算核价方法百度文库
确定时间定额应根据本企业的生产技术条件,使大多数工人经过努力都能达到,部分先进工人可以超出,少数工人经过努力可以达到或接近平均先进水平。随着企业生产技术条件的不断改善,时间定额定期进行修订,以保持定额的平均先进水平。☆铣床

消除晶圆背面减薄过程产生的异常研磨印迹的方法与流程
今天.本申请涉及半导体技术领域,具体涉及一种消除晶圆背面减薄过程产生的异常研磨印迹的方法。背景技术.在后段制程阶段,晶圆(正面已布好电路的硅片)在后续划片、压焊和封装之前需要进行背面减薄加工以降低封装贴装高度,减小芯片封装体积,改善芯片的热扩散效率、电气性能、机械性能及

